Altair解决方案概述
仿真、HPC和数据分析平台
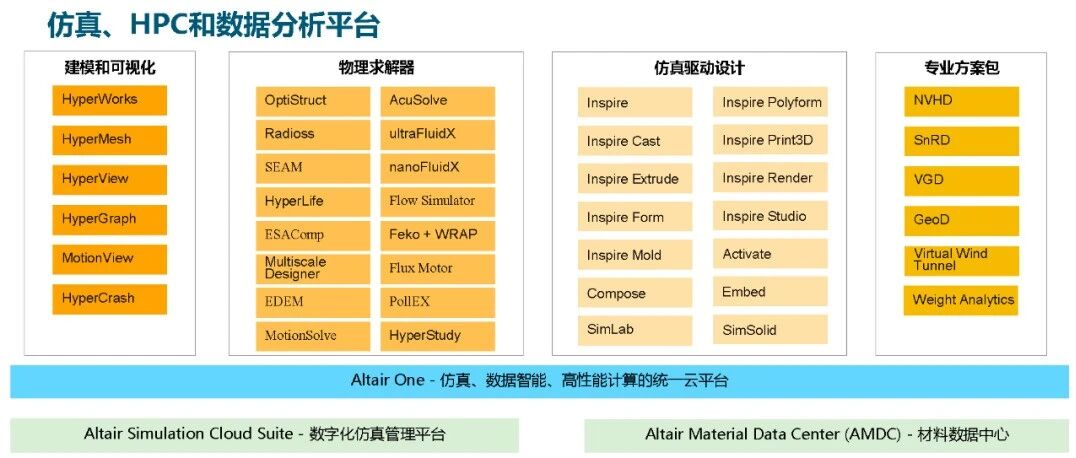
建模和可视化 | 物理求解器 |
HyperWorks | OptiStruct | AcuSolve |
HyperMesh | Radioss | ultraFluidX |
HyperView | SEAM | nanoFluidX |
HyperGraph | HyperLife | Flow Simulator |
MotionView | ESAComp | Feko + WRAP |
HyperCrash | Multiscale Designer | Flux Motor |
| EDEM | PollEX |
| MotionSolve | HyperStudy |
仿真驱动设计 | 专业方案包 |
Inspire | Inspire Polyform | NVHD |
Inspire Cast | Inspire Print3D | SnRD |
Inspire Extrude | Inspire Render | VGD |
Inspire Form | Inspire Studio | GeoD |
Inspire Mold | Activate | Virtual Wind Tunnel |
Compose | Embed | Weight Analytics |
SimLab | SimSolid |
|
HyperWorks结构前后处理解决方案
——结构前后处理一站式解决方案
● 通用前处理:HyperMesh
● 复杂几何前处理:SimLab
● 网格批处理:BatchMesher
● 二次开发接口:Tcl/Tk&Python
● 云图后处理:HyperView
● 图表后处理:HyperGraph

HyperWorks仿真平台求解器
——最广泛的优化求解器组合
● 系统仿真
● 制造仿真
● 电磁
● 结构分析
● 碰撞、安全、冲击和爆炸
● 热分析
● 流体力学
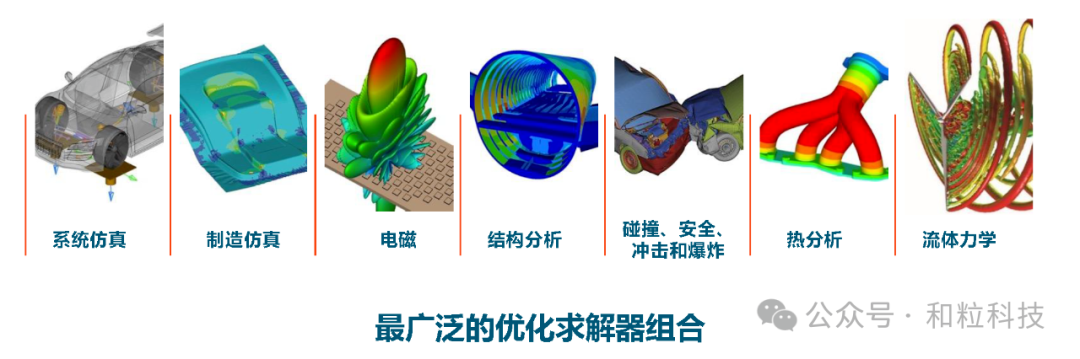
芯片及PCBA行业仿真场景
1、芯片封装及PCBA前处理建模
2、静强度分析
3、热结构耦合分析
4、动力学分析
- 模态、频响和振动
- 跌落冲击
5、SimSolid无网格分析
6、电子产品散热分析
7、Pollex
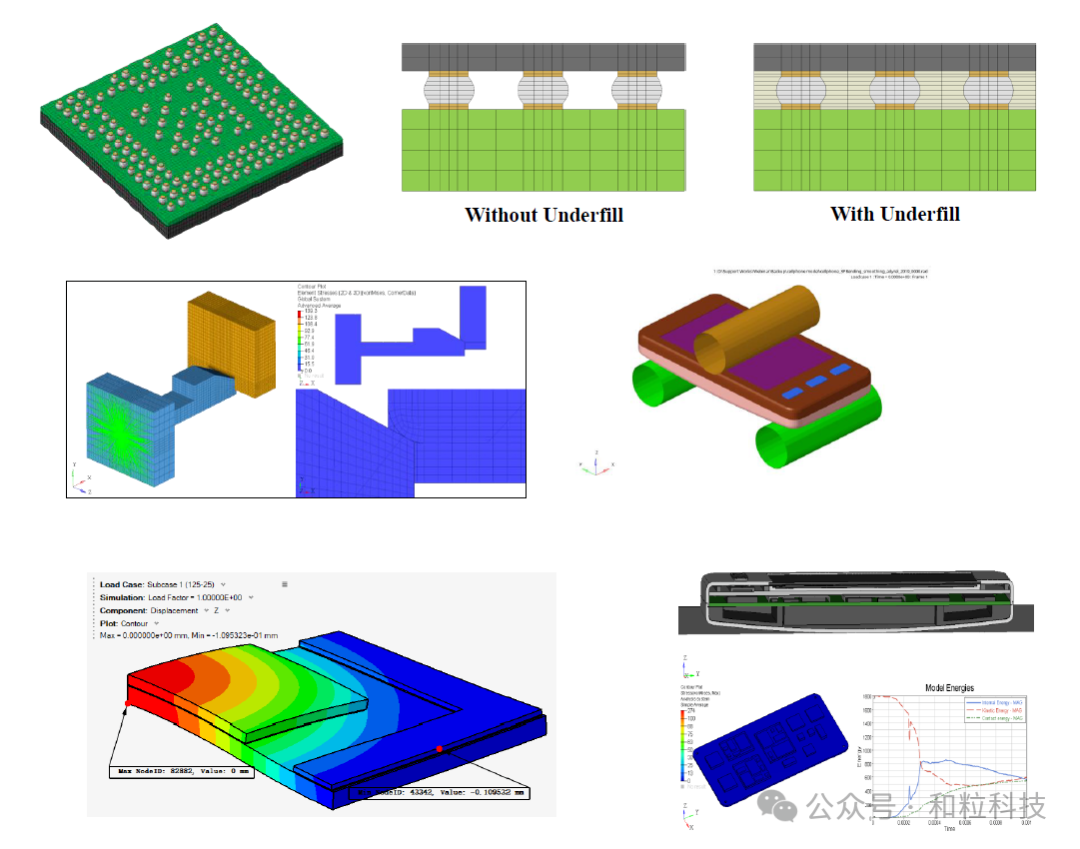
芯片封装及PCBA前处理建模
HyperMesh 高质量,高效率,开放的有限元前处理平台
● 30多年致力于CAE前处理,擅长复杂网格建模,拥有5000+商业用户
● 在汽车、航空航天、重工、轨道交通、电子等行业事实上的标准有限元前处理平台
● 与全球通用的CAD,CAE软件无缝集成
● 开放架构,为客户实现流程定制,极大地提高仿真工作的效率


过渡到全新用户界面
所有的模型,脚本,流程仍然可用 – 同样的 HM 文件,同样的底层数据库

用户界面
——多窗口显示与操作
● 支持多窗口显示
- 每页最多16个HyperMesh窗口
- 支持多窗口同步旋转、移动
- 支持窗口间的复制与粘贴


高效实体网格划分
● 四面体
● 六面体
● Mesh Control 网格控制
● 边界层网格
● 薄实体六面体网格自动划分
● 实体网格质量自动优化

优化集成于HyperMesh
● 设计探索DesignExplorer
● 完全图形交互式的DOE、优化作业创建流程
● 设计变量灵敏度直接显示于模型
● 运行结果云图可视化
● 基于机器学习的位移云图自动预测

极速查找模型关键位置!
仅在HyperWorks新界面中支持热点(Hotspot)搜索功能
● 搜索:应用过滤标准得到想要的热点
● 查看:用细节可选的方式显示热点
● 保存:在一个页面可以保存多个查询到的热点
● 比较:在多个模型上应用相同的检索条件
● 存储:共享热点检索结果和设置

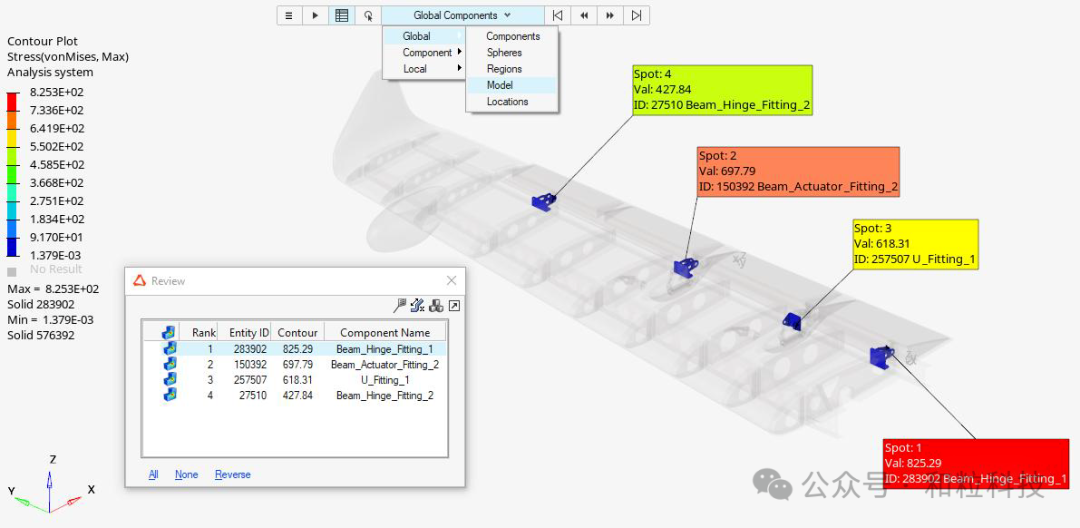
HyperWorks Report 报告自动生成

高度灵活、开放的二次开发平台
依托HyperMesh,HyperView的前后处理功能,实现:
集成化与系统化
● 与 PDM系统集成的自动建模系统
● CAE数据与报告管理系统
流程自动化
● 跌落模型创建与设置流程
● 从几何导入到装配完成的快速建模流程
● 结构分析,NVH,优化流程等
工具自动化
● 螺栓标准化建模工具
● 荷载工况创建工具
● 密封条创建工具
电子产品分析流程自动化
三星电子封装流程自动化:
● 有限元建模 ( BGA/BOC/MCP/LeadFrame/POP)
● 载荷工况 (Warpage/SJR/Drop/Tip breaking)
● 作业提交 (将作业自动提交到计算集群上)
● 后处理 (自动化的分析报告生成)
数据的管理:
● 流程驱动的数据管理
● 能够处理所有类型的仿真数据与实验数据
使用流程自动化效果:
● 极大缩短项目时间并减少错误
● 标准化的CAE流程
● 实现重要数据的可重用性
● 提升整个CAE流程的可靠性
● 实现有效的合作机制

芯片封装六面体网格划分流程

芯片封装Bump自动阵列
——封装级别、bump 应力分析
● 将近17000个bump模型阵列
● 为减少总网格数,结合简化模型与详细模型
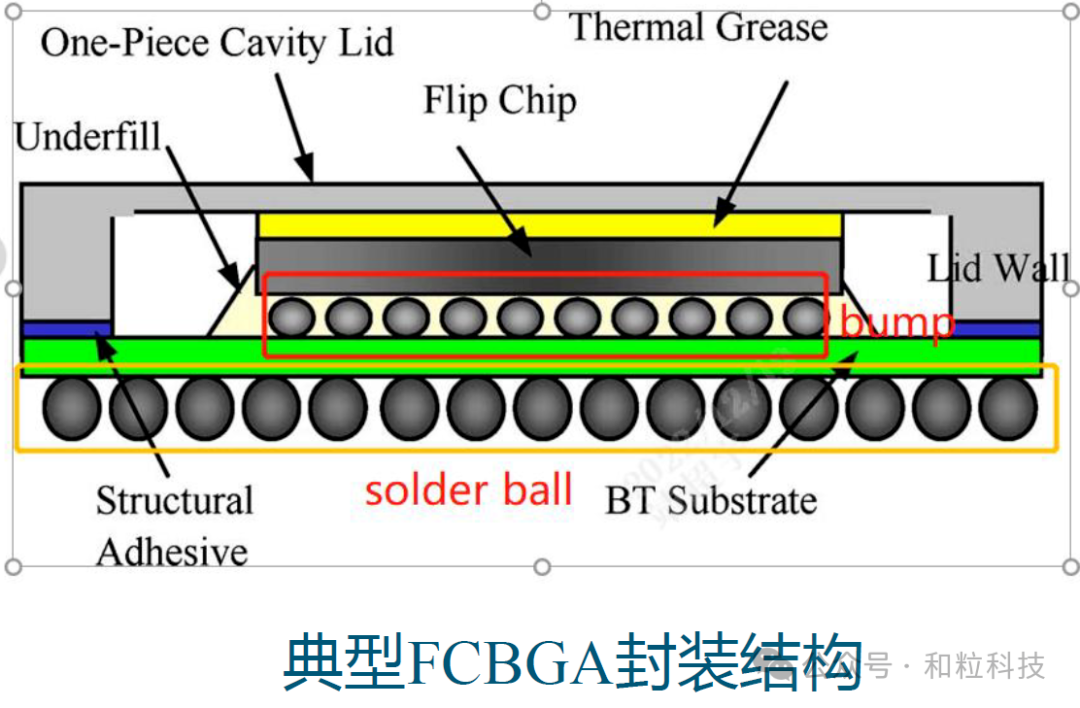
● 建模需考虑效率问题
● 允许用户输入位置信息,调用不同模型

芯片封装Bump自动阵列
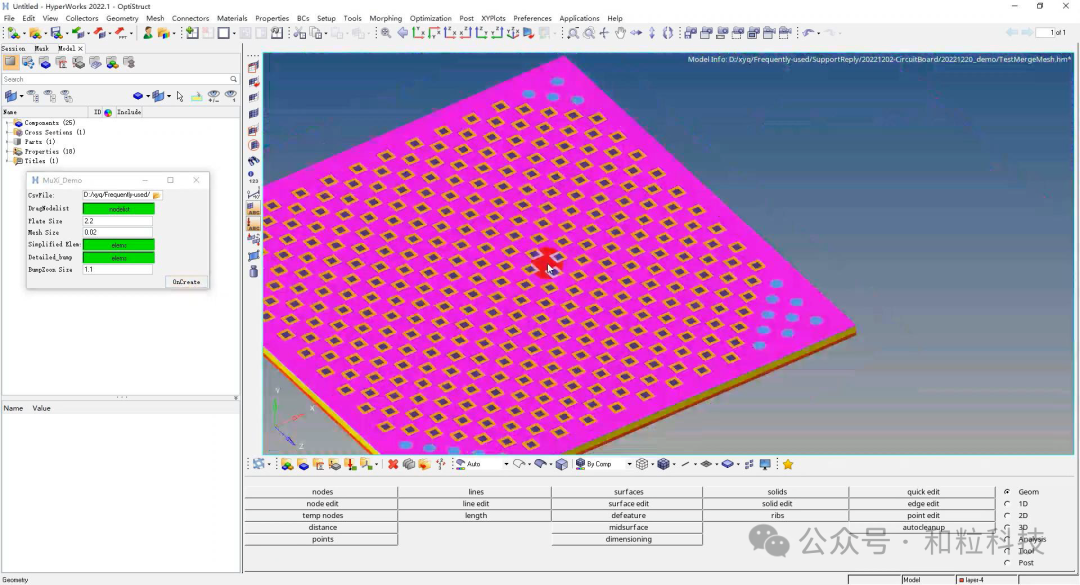
流程化的电子产品可靠性仿真平台
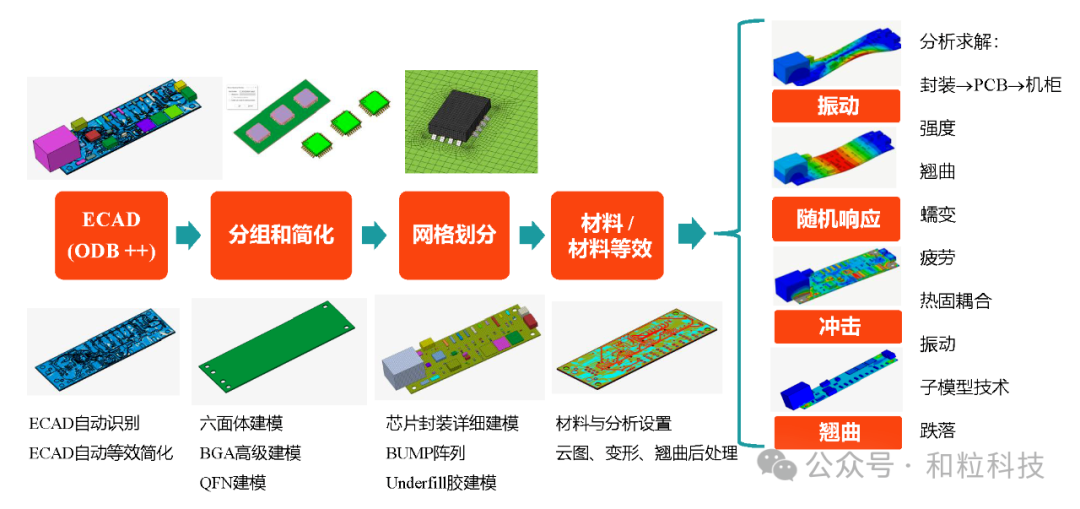
直接读取ECAD源文件
● 直接读取PCB的ECAD源文件,自动生成分层几何
● 支持对PCBA几何模型快速简化
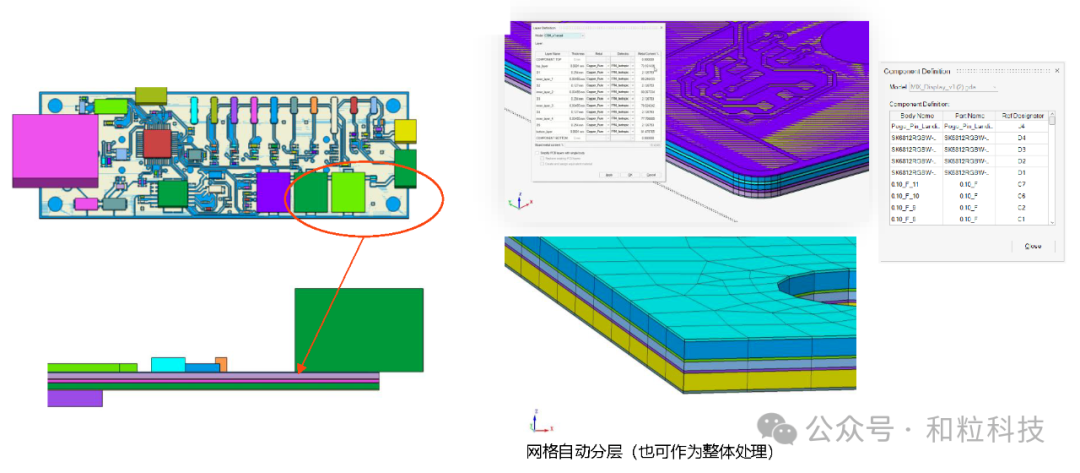
PCB板快速建模及材料等效
● 支持直接导入ECAD文件,并自动生成实体/壳/线几何
● 可快速简化PCB板并生成六面体网格,可自动贴合
● 根据铜线分布生成等效的随温度变化的正交各向异性材料参数,可捕捉Z向材料性能变化
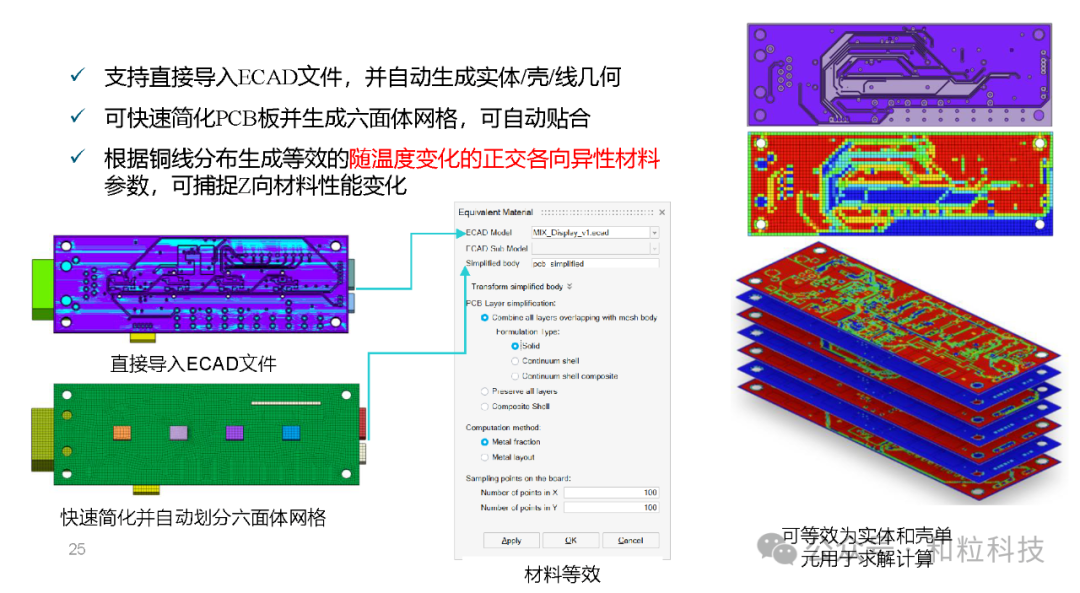
基于特征识别的高效网格划分
● 选择相同面
● 识别螺栓/回转体/管路等
● 识别重复零件
● 选择相同零件
● 根据尺寸识别零件

焊球快速建模与简化
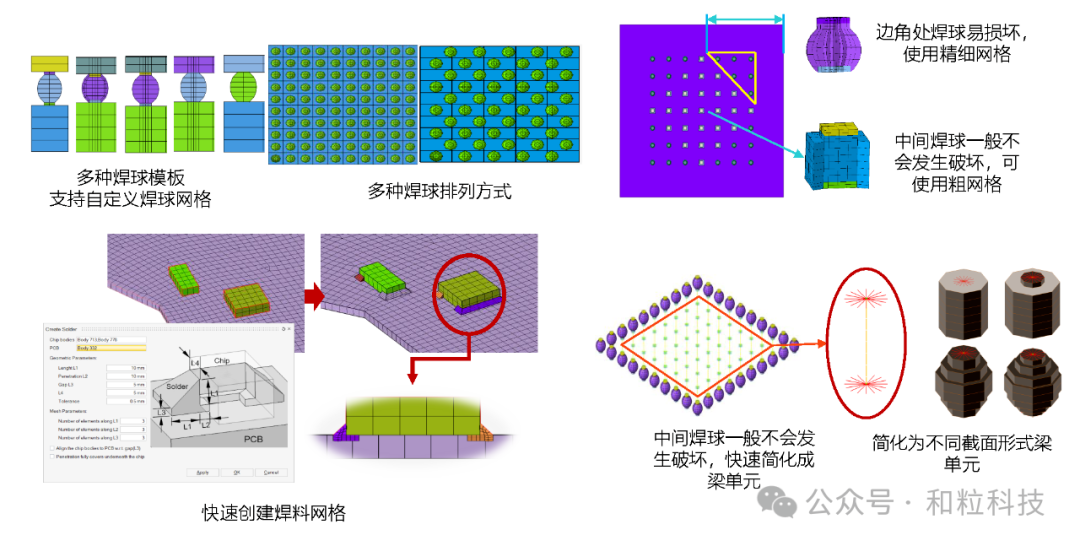
BGA网格简化

包含Bumps的详细BGA建模
先进的BGA封装内部具有大量的bumps(凸点),并且需要划分六面体网格,所以整体BGA网格划分往往需要数天。采用SimLab+HyperMesh的方式,可以将整个网格划分过程用时降至2个小时。

PCBA的网格划分
为PCB板快速建立六面体网格。
支持将PCB从中间切分为两半,然后通过Tie连接。这两半网格将分别与PCB板上下方的零件共节点。
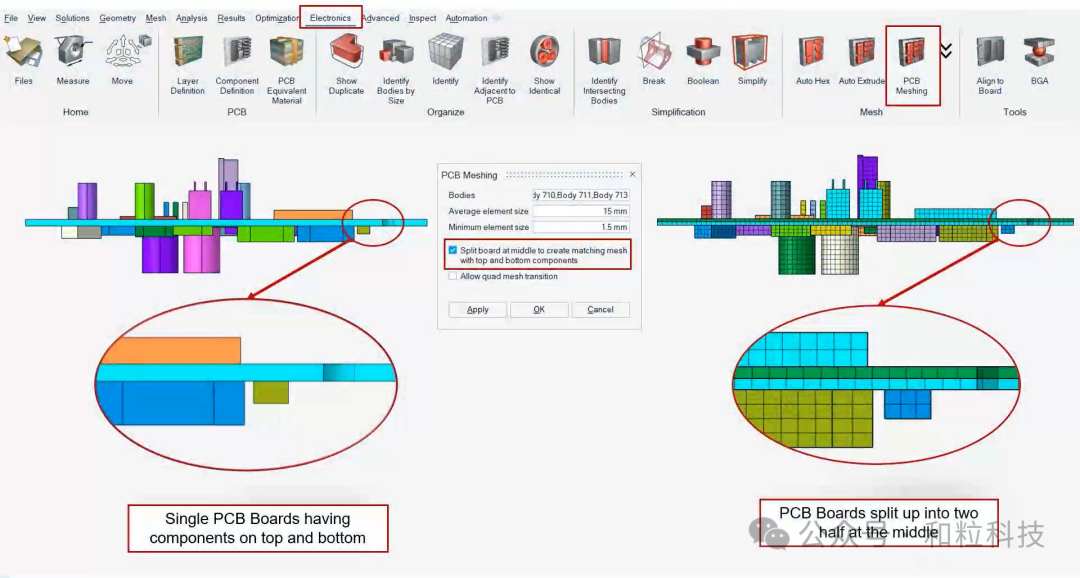
Chip Underfill Weld
——Underfill胶建模
添加一个工具用以在die和基板之间创建共节点的有角度underfill. 这个工具需要underfill的宽度和高度作为输入。
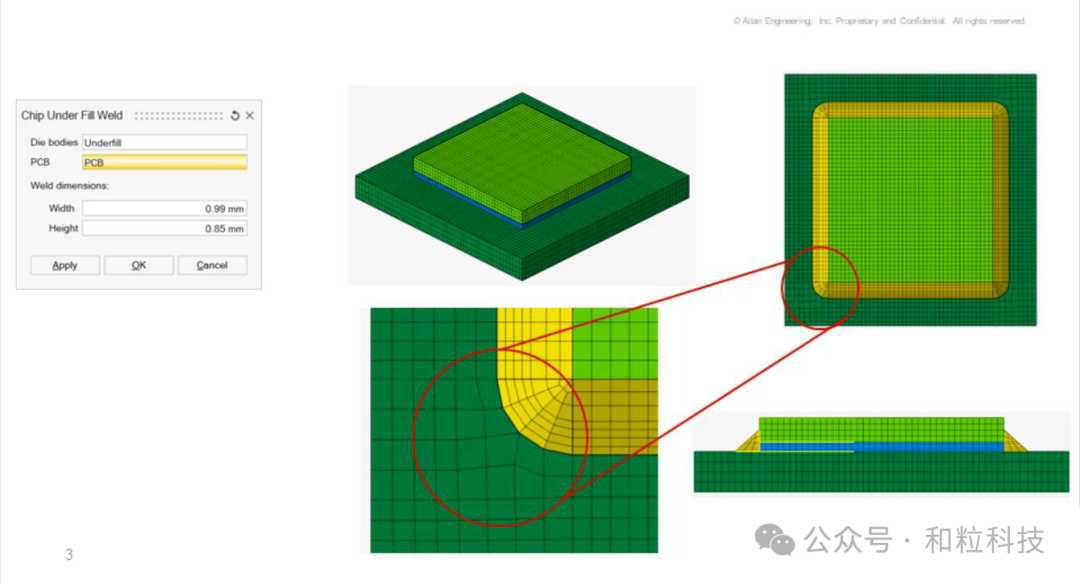
3D Chiplet参数化建模
——3D堆叠chiplet建模
● 3D-IC技术是指多芯片集成电路的一系列封装技术,其中多个半导体芯片(称为“chiplets”)彼此靠近放置(2.5D-IC)或堆叠在一起(3D-IC).
● 这些小芯片使用带有通硅孔(tsv)的硅中间层互连,tsv穿透硅中间层并实现所有层之间的连接.
● 该技术允许在逻辑、存储器、传感器、微机电系统(MEMs)等领域的芯片进行异构集成,并以紧凑的外形因素实现更高的性能、更低的功耗和更小的尺寸规格.
● 这个工具有助于根据给定的参数创建芯片堆叠模型进行布局分析
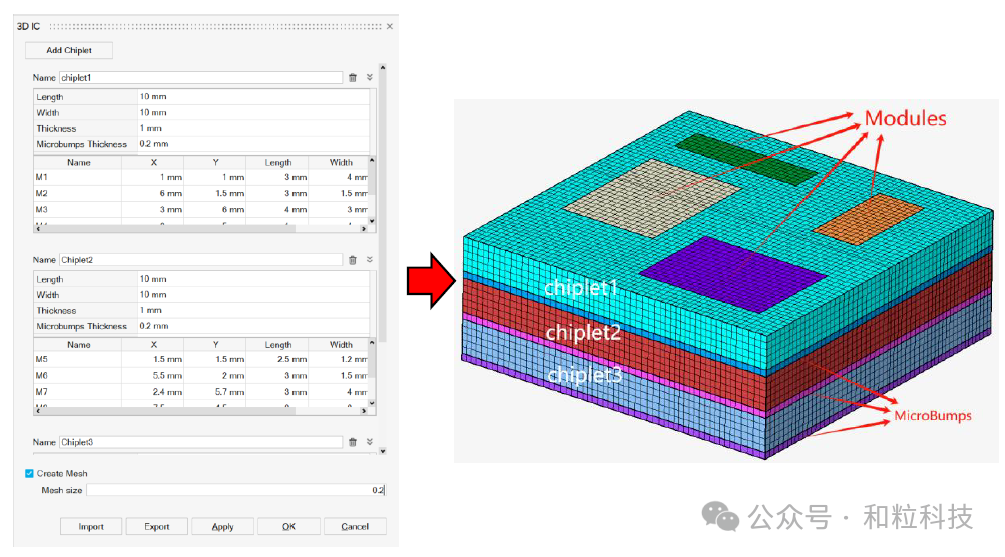
静强度分析
OptiStruct的结构分析能力
● 线性/非线性静力学
● 瞬态分析
● 模态分析
● 频响分析(模态法,直接法)
● 随机振动
● 稳态/瞬态传热分析
● 翘曲分析(支持热固强耦合)
● 焊球疲劳(蠕变材料)
● 跌落仿真
● 电-热-固耦合分析

静强度:静力学
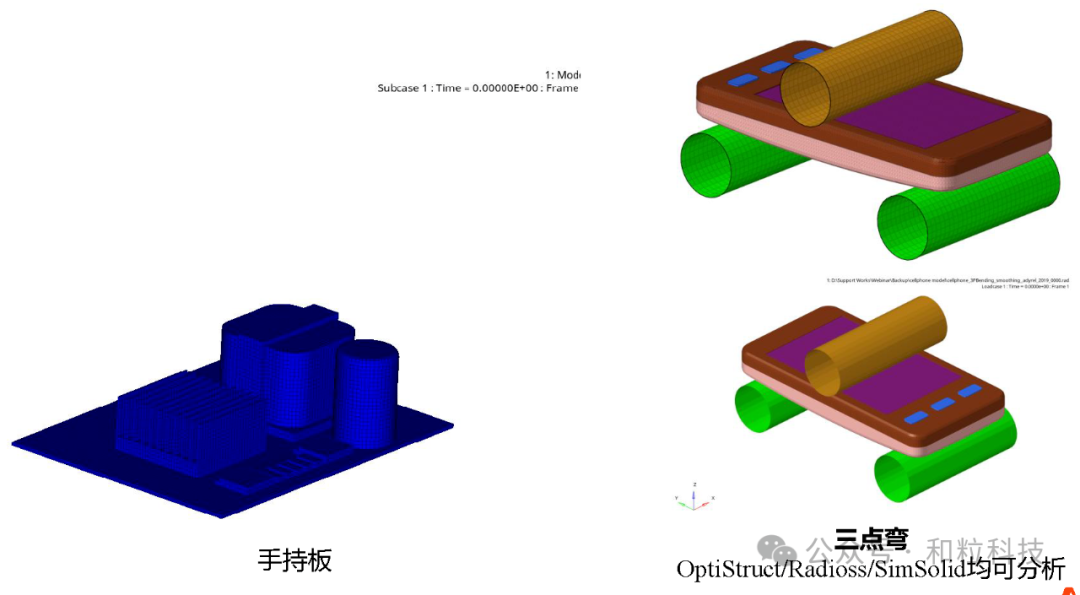
结构刚强度分析
● 卡扣插拔
● 散热器安装
● 雷达风载变形
● 非线性弹性橡胶密封仿真
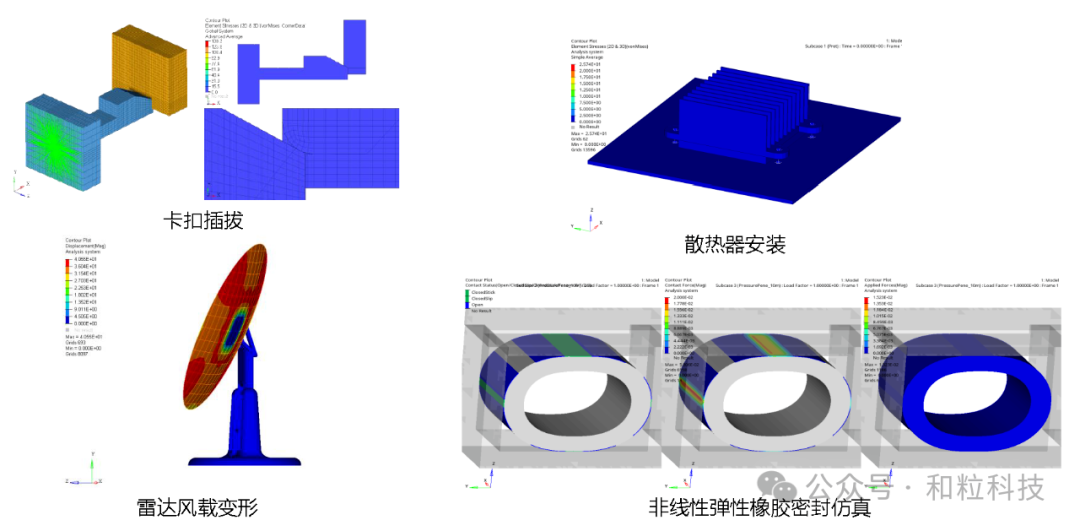
静强度-粘胶开裂/脱离
胶粘及材料
● 无损伤类型 MCOHE
● 有损伤类型MCOHED

● 支持具有胶粘特性的接触对

电子基本的加强筋优化设计
基于OptiStruct 拓扑优化对电子器件的基板加强筋分布进行设计。在不增加材料质量的前提下,以提高基板刚度,降低基板变形为目标,来对基板的加强筋的分布进行拓扑优化。
参照基板上电子元器件的布置情况和拓扑优化的结果,重新排布加强筋在基板上的位置,得到优化后基板的改进设计。对比基板原始设计和改进设计在相同工况下的有限元模型的刚度计算结果,证明应用拓扑优化的方法来改进此基板加强筋的分布是合理和可行的。
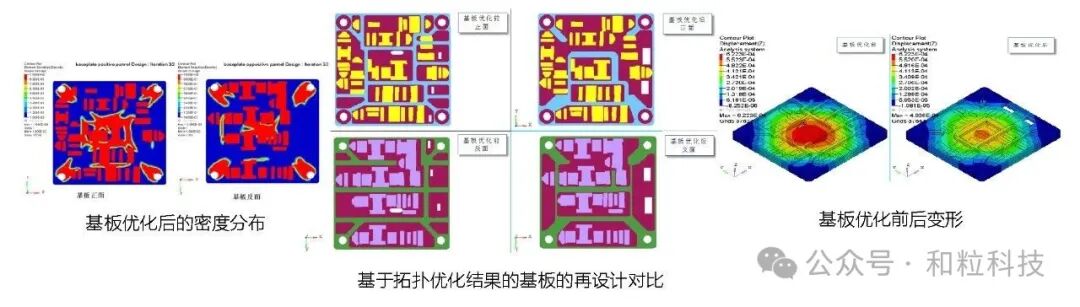
热结构耦合分析
PCB回流翘曲
SimLab直接导入ECAD源文件,自动生成包含铜层线路的详细PCB几何。在SimLab中自动创建PCB的详细网格,自动赋予FR-4和铜箔材料属性。加载温度载荷后计算PCB翘曲,创建对角线节点路径并提取翘曲度。
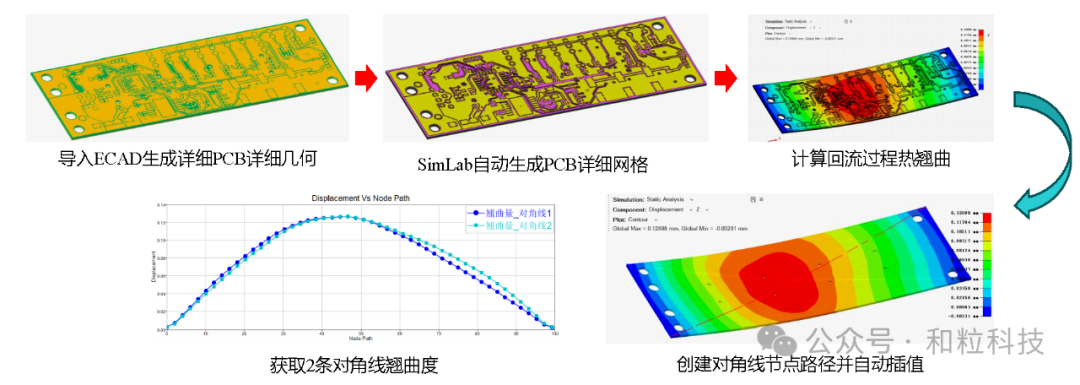
封装结构热可靠性:芯片封装翘曲
OS进行热-结构耦合应力分析
● 芯片封装各部分的CTE差异导致的翘曲
● 温度场数据可来自热分析计算结果直接映射
● 温度场点阵数据可作为结构应力分析的输入
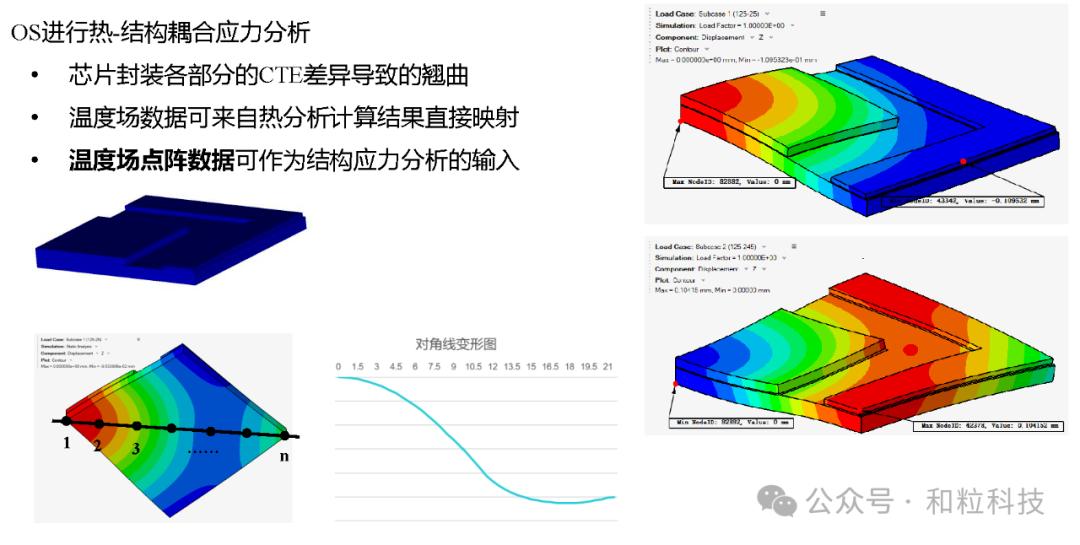
封装结构热可靠性:焊球疲劳
● 焊球疲劳求解方案,自动创建蠕变工况及疲劳工况参数
● 支持多种蠕变材料本构: Anand,Darveaux,Hyperbolic Sine Hardening等
● 支持如下三种焊球专用疲劳算法:Syed-Creep energy density,Syed-Creep strain,Darv-Creep energy density
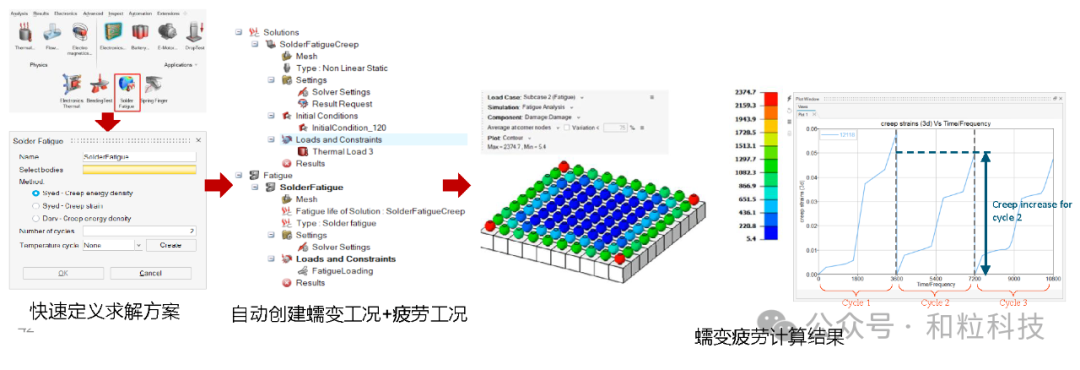
芯片封装结构热可靠性:子模型技术
两步完成子模型定义,快速计算子模型上详细变形、应力、应变以及疲劳寿命
● 定义子模型材料参数
● 定义全局模型与子模型交界面,自动将全局模型位移映射到与子模型的交界面

SimLab电-热-结构耦合分析
在SimLab中可以方便地创建电-热-结构耦合分析,计算电流产热造成的结构变形和应力。
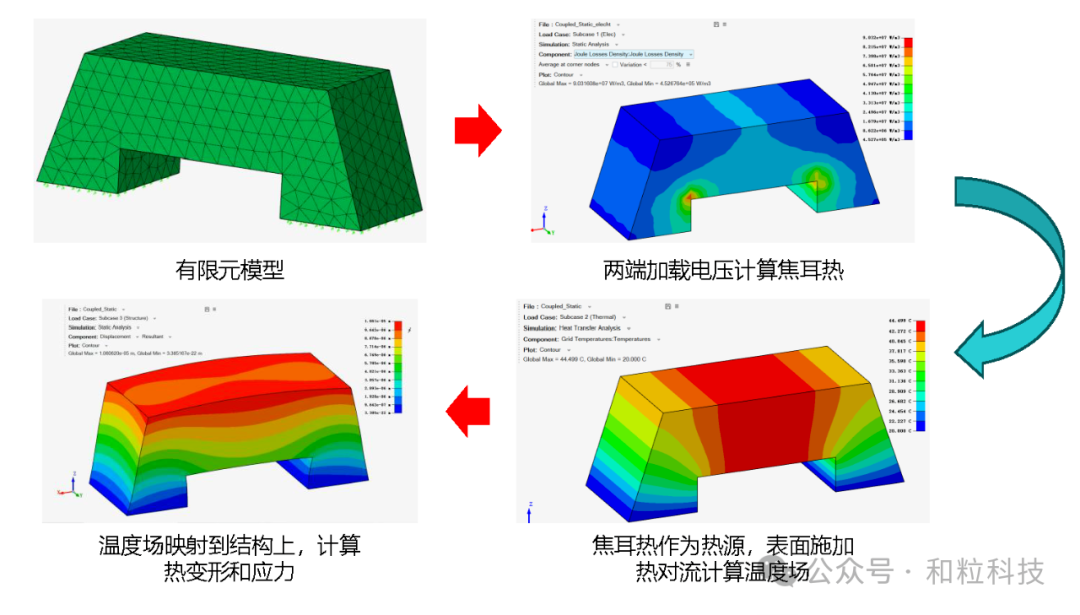
动力学分析
结构冲击响应:电子设备冲击
● 电子设备在运输、携带、使用过程中可能承受各种负载和冲击。因此,在产品设计过程中,需要考虑易碎组件,如主板等如何布置以更好的保护其在因各种冲击下不产生损坏。
● 通常,对于其抗冲击性能,往往需要在实验台开展周期较长、成本昂贵的三角、阶跃或半正弦等脉冲冲击下的机械抗冲击测试。
● 通过仿真分析易损电子元件的冲击响应,可以大大的缩短研发周期,节约研发成本


结构冲击响应:基于响应谱的抗冲击仿真

结构冲击响应:基于瞬态分析的抗冲击仿真

结构动力学可靠性:模态分析
● OptiStruct支持Lanczos方法、AMSES模态加速法,可以快速有效的分析结构模态,避免结构共振。
● OptiStruct还提供预应力条件下的模态分析,只需顺序依次设置,即可完成求解。
- 考虑电子产品在工作温度下由热引起的热应力预载荷
- 考虑电子产品在离心力等预载荷作用下的模态
- 螺栓预紧、过盈配合等装配过程中产生的预应力模态


结构动力学可靠性:频响
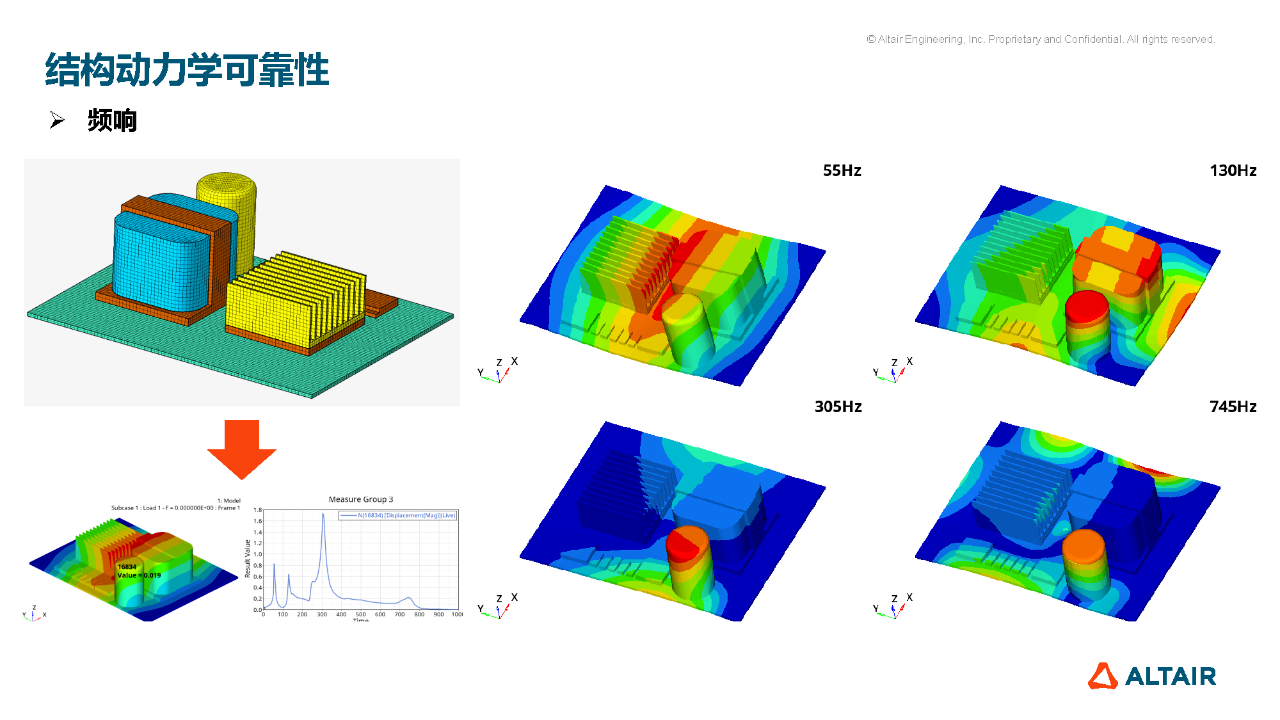
结构动力学可靠性:随机振动

疲劳分析:疲劳
OptiStruct的疲劳分析用户只需直接在一个模型中定义静力分析和疲劳分析工况,支持S/N高周应力疲劳和E/N低周应变疲劳分析功能,
● 单轴疲劳支持高周和低周疲劳
● 多轴疲劳支持低周疲劳
● 基于Dang Van方法的无线寿命疲劳
● 焊缝、焊点疲劳
● 基于随机响应下疲劳
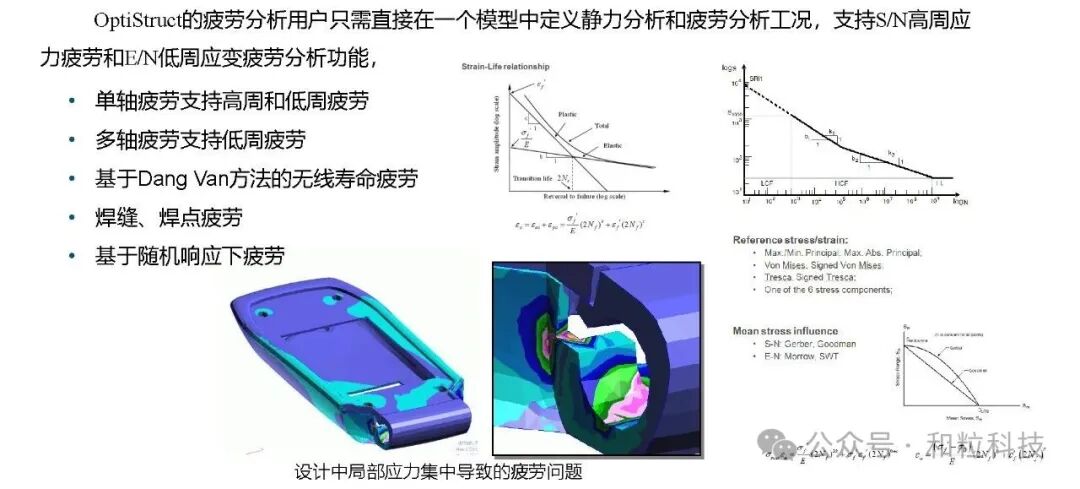
Radioss显式动力学分析:显示动力学案例
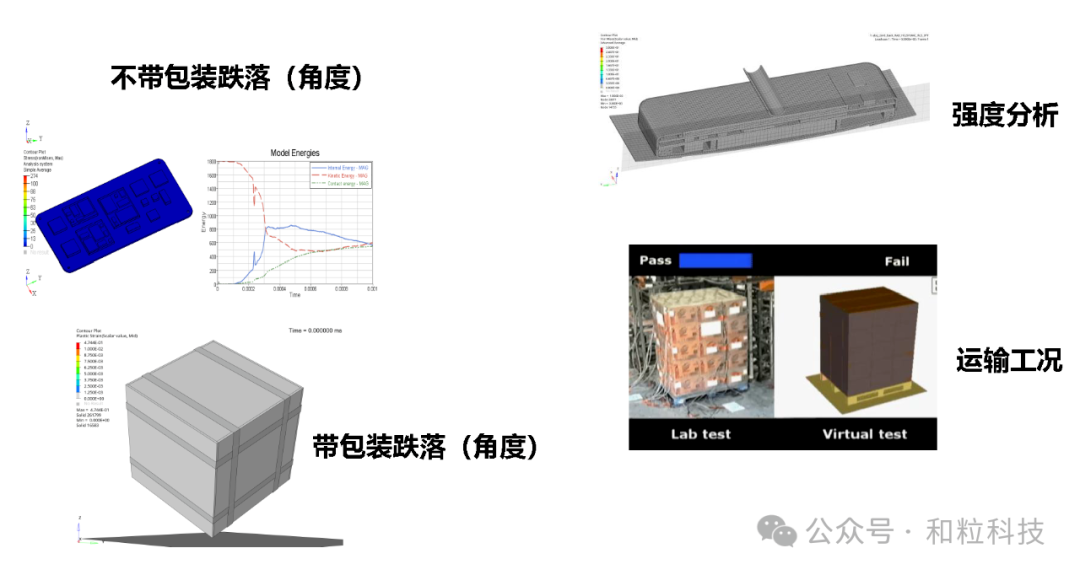
跌落分析:PCB板跌落分析
查看绑定接触力/ANIM/VECT/CONT2
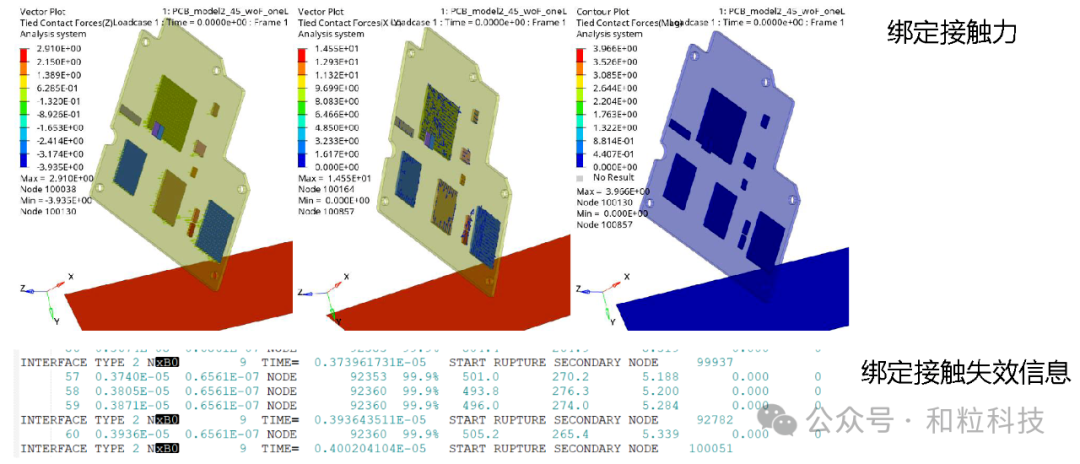
跌落分析:PCB板带预紧跌落分析
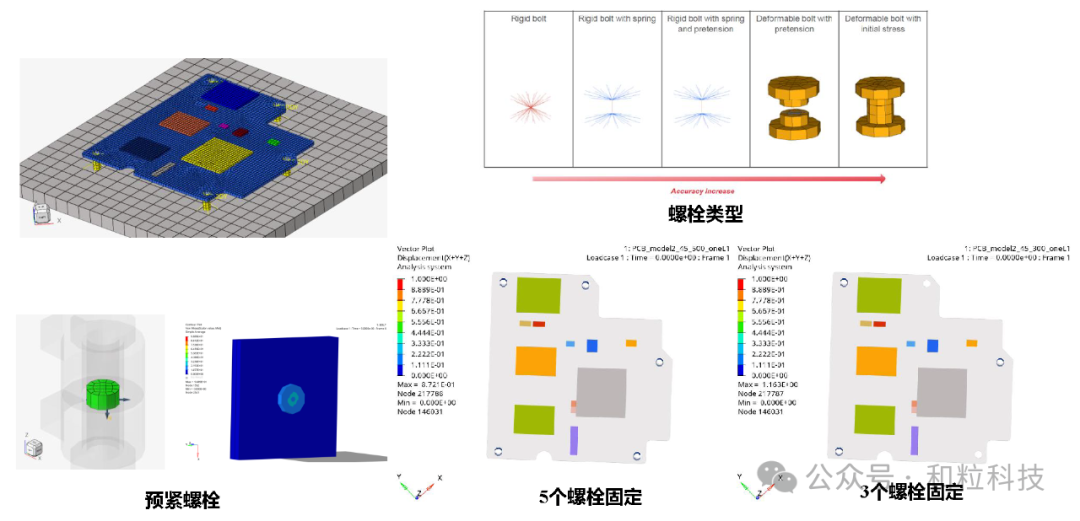
SIMSOLID无网格法快速分析
有限元技术的革新⎯SimSolid无网格分析方法
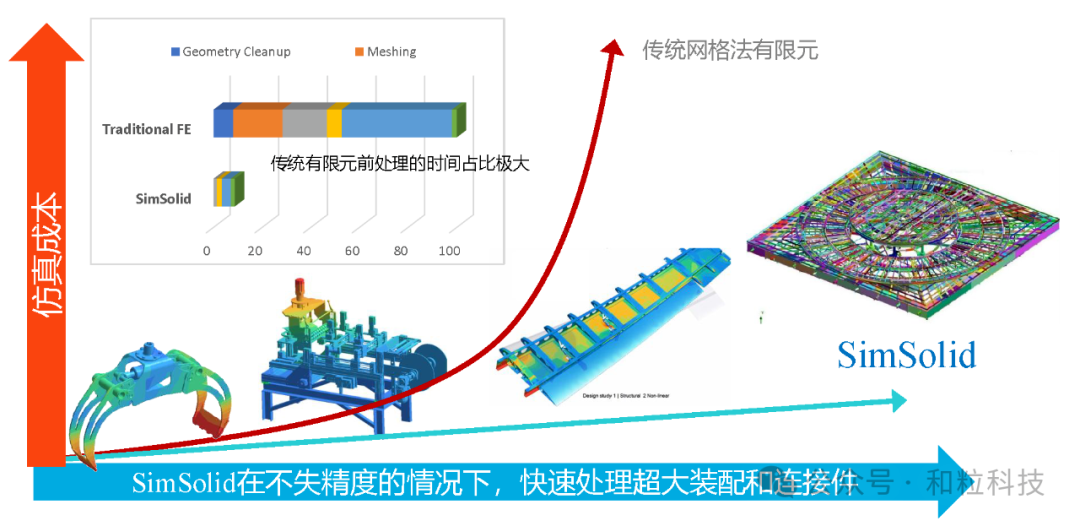
SimSolid的分析功能
● 静强度分析
● 模态分析
● 热分析
● 瞬态/频响/随机振动分析
● 螺栓预紧分析
● 大变形/接触/弹塑性
● 热固耦合分析
● 疲劳分析

静强度分析:静力学+模态分析
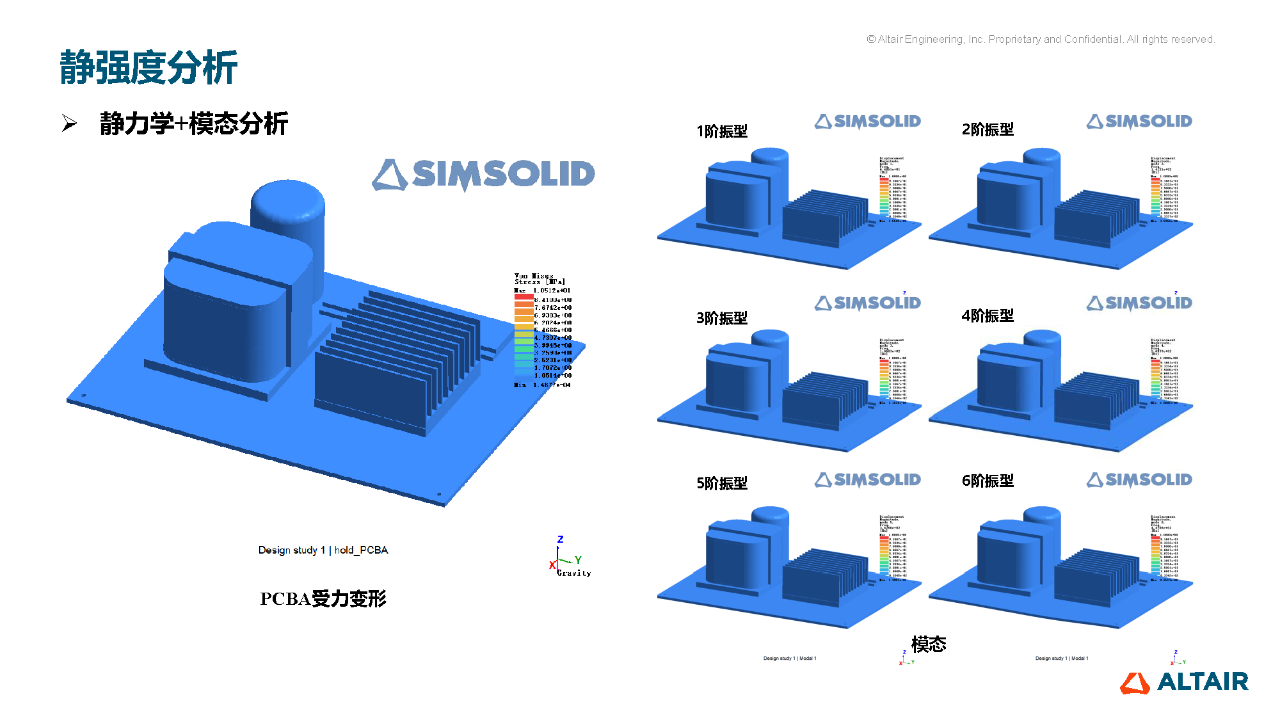
热固耦合-深南电路:MCM-BGA 封装体运行温度及热应力分析与优化设计
项目背景:MCM-BGA封装体共包含9个芯片,每个芯片表面的热功率为50W/cm^2,通过封装体表面和散热外壳冷却通道散热。优化封装基体厚度和散热基体厚度,确保芯片工作温度和避免热应力导致的开裂。
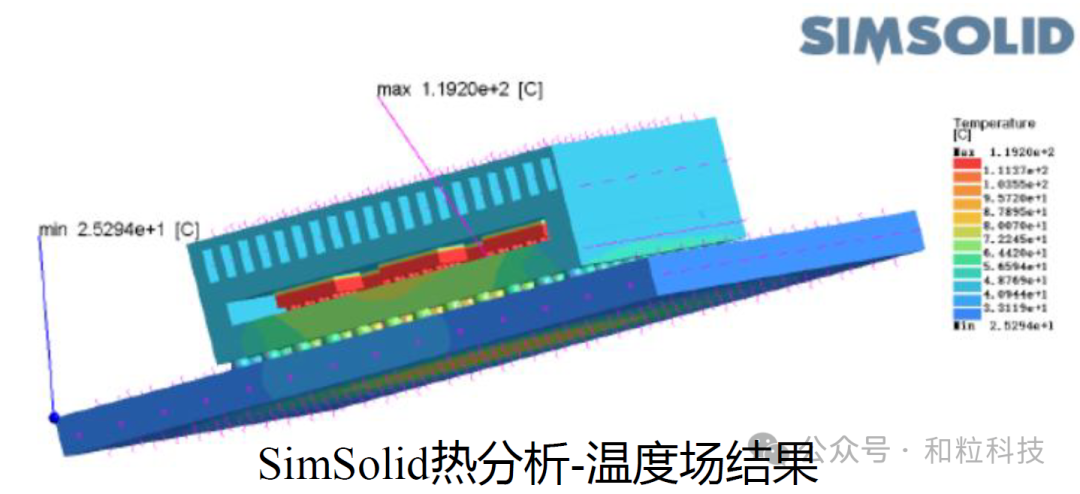
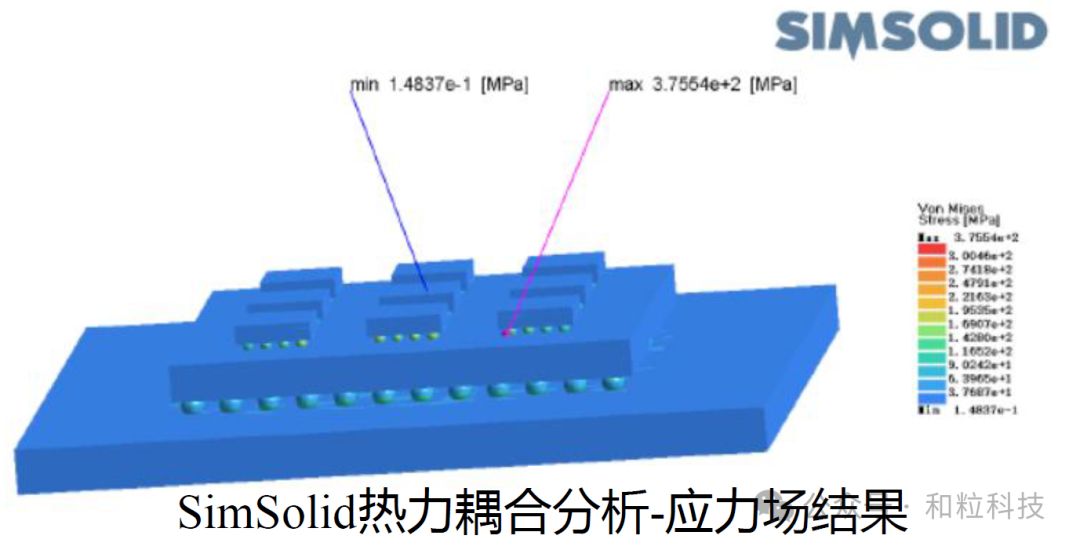
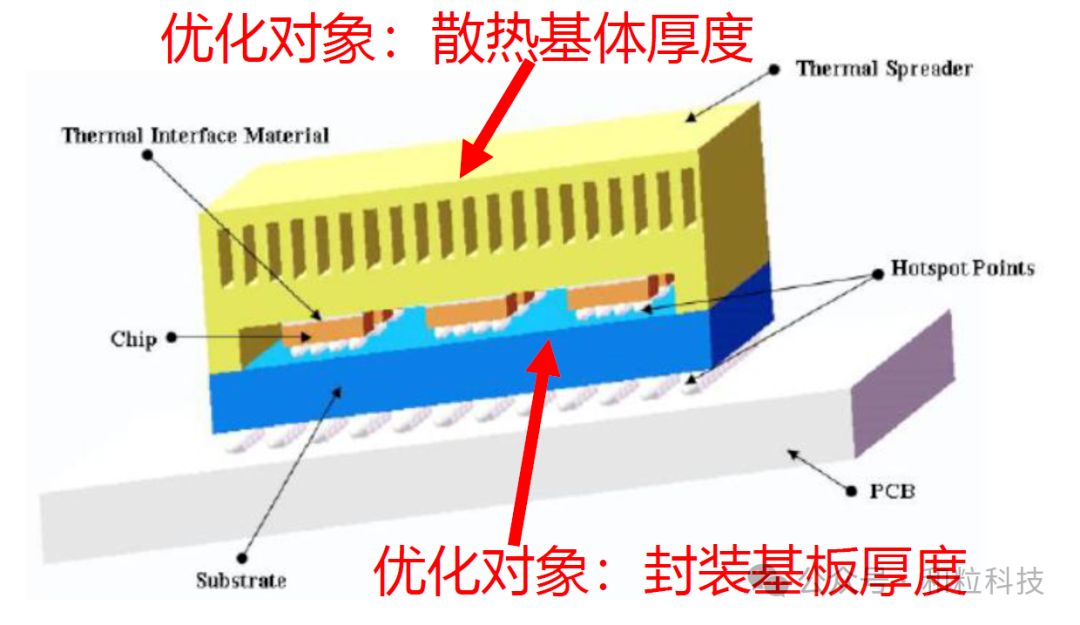
动力学仿真:频响+随机振动
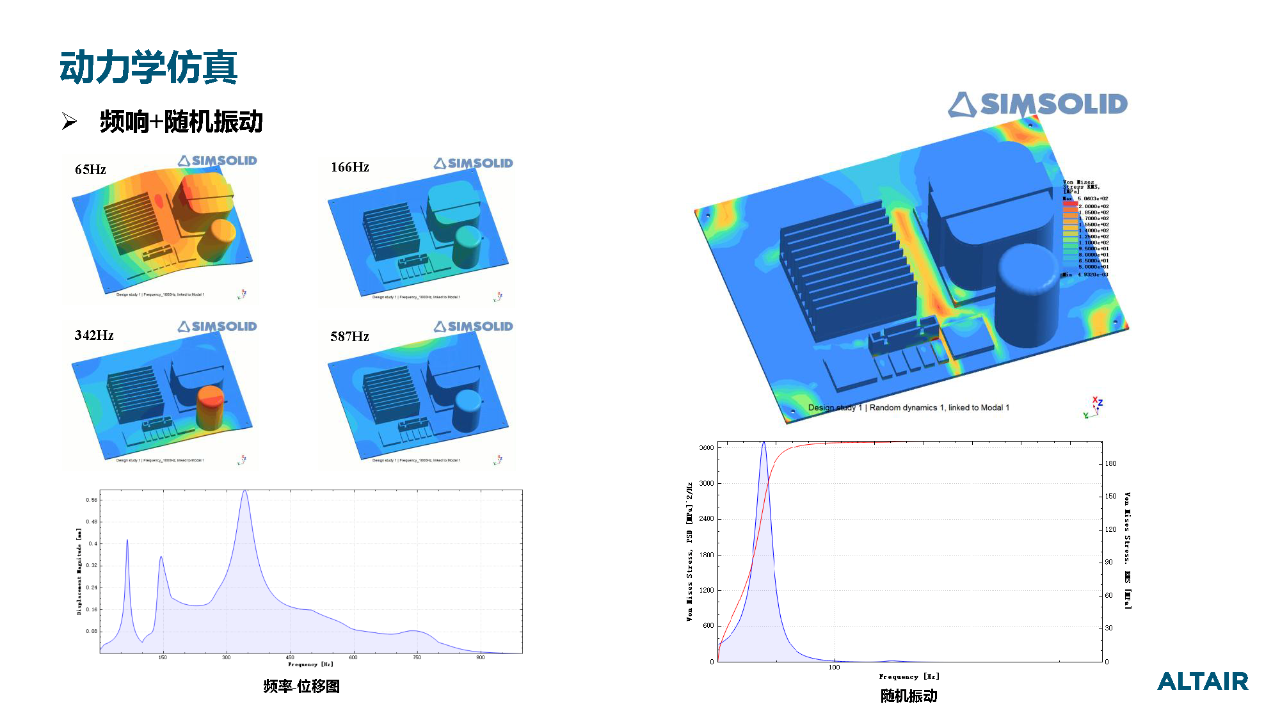
电子产品散热分析
SimLab+ElectrFlo功能介绍
——流程简单, 复杂模型, 结果准确
多物理场
● 电气、热、流
● 湍流& 瞬态
● 常见电子元件Smart Objects

工作流程
● 基于CAD的前处理建模
● 容易处理复杂MCAD & ECAD模型
● Dynamic setup
● 自动报告

用户体验
● 操作方便,容易上手
● 快速建模
● 快速设计变更
● DOE
● 与Altair其它工具关联
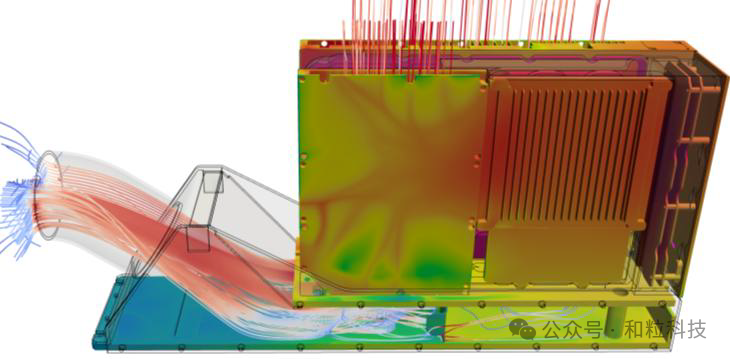
案例 1: 板级热分析
● PCB 含2层铜层 (0.03mm)
● Non-CFD


案例 2: PCB元件散热
板级模型,包含:
● 1 块PCB
● 数十颗IC元件
模型设定:
● PCB模型包含铜线
● 自然对流

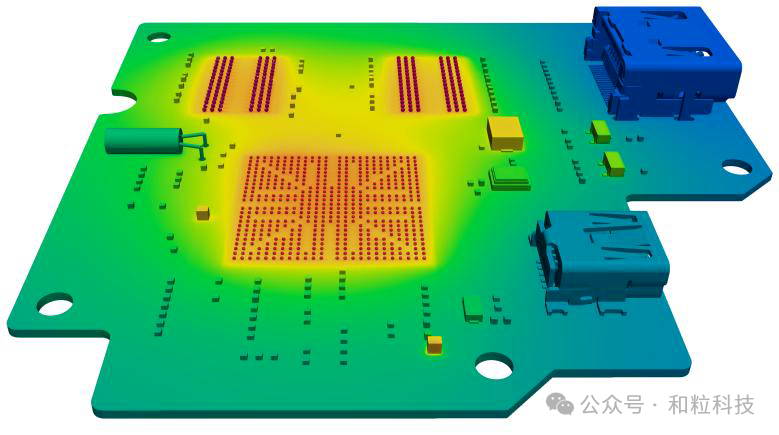
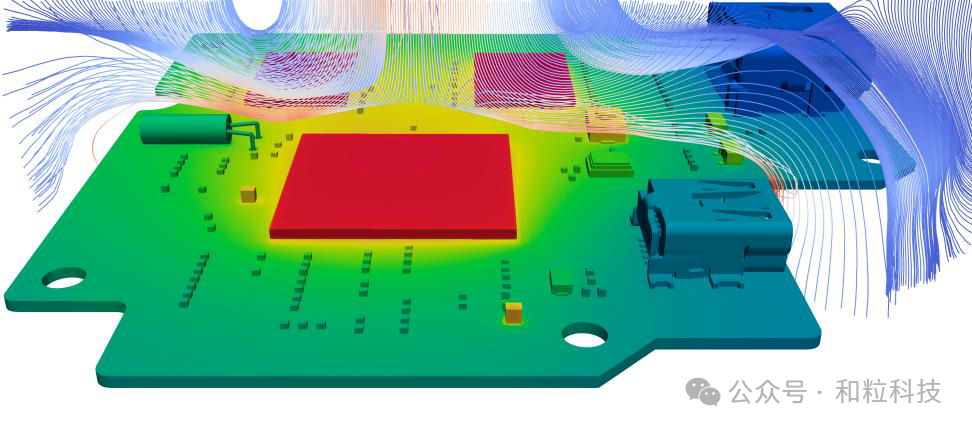
POLLEX
PollEx:简介
Altair PollEx是一款涵盖PCB设计审查、验证、分析和制造的PCB级EDA软件套件,可显着缩短开发周期,同时为原理图工程师、PCB设计师、CAE分析师和制造工程师提供通用应用程序便于沟通
● PCB绘制和ECAD互通
● PCB验证(DFE, DFM, DFA)
● PCB仿真(SI / PI / Thermal)
● 统一部件编辑器
● 原理图 / CAM
● 制造
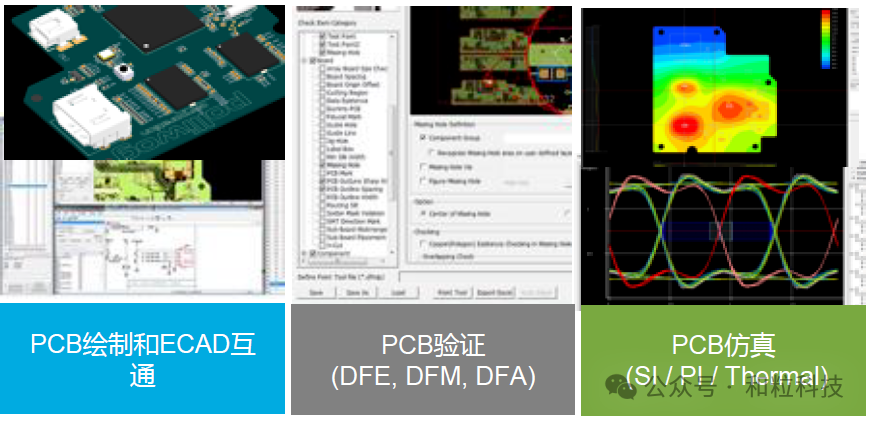

PollEx:PollExPCB验证
● 通过将后期设计引入早期设计阶段,DFx是显著减少PCB设计迭代和成本的关键
● 检测可能在制造(DFM)、装配(DFA)或引起电气故障(DFE)期间发生的设计故障。
● 可定制的基于规则的检查,快速检查数千个标准
● 验证中包含仿真数据(使用PollEx DFE+时)

PollEx:PollEx PCB仿真
● 快速,准确和简单的PCB SI分析仪
● 网络拓扑分析仪可以创建/修改信号的拓扑结构并对其进行分析。

● 基于有限元法的考虑传导、对流和辐射的板级热分析
专门用于在早期设计阶段进行快速准确的热分析具有自动网格划分和内置材料库的有限元分析
● 分析与决策
热轮廓和结温可以考虑散热器,热通孔和楔形锁吗是否可以在PCB上应用单个元件的工作功率和局部边界条件